6월 파일럿 완공…AI 칩 대형화에 '패널 공정' 전환
자이 AP7 거점 부상…美 애리조나도 패키징 투자 병행
[아이뉴스24 권서아 기자] 세계 1위 파운드리 기업 TSMC가 첨단 패키징 전략을 기존 '칩 온 웨이퍼 온 서브스트레이트(CoWoS)' 중심에서 패널 기반 '칩 온 패널 온 서브스트레이트(CoPoS)'로 확장하며 생산 체계 전환에 속도를 내고 있다.
13일 대만 중앙통신사(CNA)와 공상시보, 경제일보 등을 인용한 트렌드포스에 따르면 TSMC는 CoPoS 파일럿(시험) 라인 구축을 진행 중이며, 오는 6월 완공을 목표로 하고 있다. 장비 반입은 이미 지난 2월 시작된 것으로 전해졌다.
업계는 2028~2029년 양산을 예상하고 있다.
![미국 애리조나주에 있는 TSMC 공장. [사진=Taiwan News·CNA 캡처]](https://image.inews24.com/v1/23407794bbe5d4.jpg) 미국 애리조나주에 있는 TSMC 공장. [사진=Taiwan News·CNA 캡처]
미국 애리조나주에 있는 TSMC 공장. [사진=Taiwan News·CNA 캡처]CoPoS는 기존 웨이퍼 기반(CoWoS) 대비 생산 효율을 높일 수 있는 차세대 패키징 기술이다. 인공지능(AI) 칩 크기가 급격히 커지면서 기존 12인치(300㎜) 웨이퍼에서는 생산성이 급격히 떨어지고 있다.
엔비디아의 차세대 그래픽처리장치(GPU) '루빈(Rubin)'은 기존 대비 약 5.5배 수준으로 커져, 웨이퍼 한 장에서 생산 가능한 칩 수가 4~7개 수준까지 줄어든 것으로 알려졌다.
이에 업계는 사각 패널 기반 공정을 통해 생산성을 끌어올리는 방안을 대안으로 보고 있다. 장기적으로는 '실리콘 인터포저(기판, 칩 등을 연결하는 데 쓰이는 부품)'를 유리 기판으로 대체하는 방안도 검토되고 있다.
다만 패널 크기 확대에 따른 기판 뒤틀림(워페이지) 문제는 상용화의 주요 변수로 꼽힌다.
![미국 애리조나주에 있는 TSMC 공장. [사진=Taiwan News·CNA 캡처]](https://image.inews24.com/v1/576b79c7da24e2.jpg) TSMC의 첨단 패키징 전략 로드맵. [자료=트렌드포스·커머셜 타임즈·CNA·TSMC]
TSMC의 첨단 패키징 전략 로드맵. [자료=트렌드포스·커머셜 타임즈·CNA·TSMC]TSMC는 자이 지역을 CoPoS 핵심 거점으로 육성할 계획이다. 자이에는 CoPoS를 비롯해 'SoIC(시스템온IC)', 'WMCM(웨이퍼 레벨 멀티칩 모듈)'을 통합한 생산 체계가 구축될 전망이다.
업계에서는 해당 지역이 첨단 패키징 7공장(AP7)의 중심 역할을 맡을 것으로 보고 있다.
TSMC는 일부 8인치(200㎜) 공장을 첨단 패키징 라인으로 전환하는 한편, 후공정 시설은 2나노(나노미터·1㎚는 10억분의 1m) 공정 대응을 지원하는 방향으로 고도화하고 있다.
기존 패키징 라인도 고도화한다.
대만에서 운영 중인 신주 1공장(AP1)은 신주와 타이중에서 생산되는 2㎚ 공정 칩에 필요한 첨단 패키징을 맡는다.
타오위안 룽탄 3공장(AP3)은 애플 등 주요 고객사의 고성능 프로세서 패키징을 담당할 것으로 전해졌다.
타이중 5공장(AP5)은 팹(Fab·공장)25에서 생산되는 2㎚ 물량을 뒷받침한다.
주난 6공장(AP6)은 SoIC·CoWoS·InFO 및 테스트 기능을 통합한 핵심 거점으로 운영되고 있다.
TSMC는 올해 자본지출(CAPEX)을 최대 560억달러(약 83조원)로 제시하며 역대 최대 수준의 투자를 예고한 바 있다. 이 중 10~20%가 패키징과 테스트 등에 배정된다. 첨단 패키징 매출 비중도 지난해 8%에서 올해 10%로 확대될 전망이다.
미국에서도 생산 확대가 병행된다. TSMC는 애리조나주에서 첨단 패키징 공장을 구축해 2028년 양산에 돌입하고, 2029~2030년 추가 라인을 가동할 계획이다. 주요 고객인 AMD, 엔비디아 수요에 대응하기 위한 조치로 풀이된다.
/권서아 기자(seoahkwon@inews24.com)포토뉴스








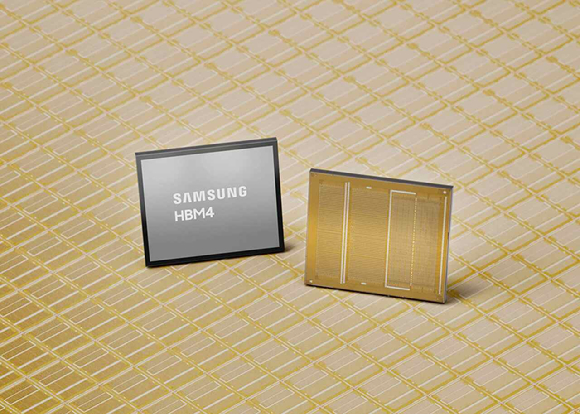






![[부음] 정병묵(이데일리 산업부 차장)씨 장모상](https://img.etnews.com/2017/img/facebookblank.png)


 English (US) ·
English (US) ·